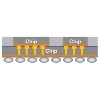 Ранее мы уже сообщали о планах TSMC по техпроцессам на ближайшие годы. В 2022 году компания уже запускает 3-нм техпроцесс, а N6 и N4 будут представлять собой оптимизированные версии 7- и 5-нм техпроцессов. С учетом все уменьшающихся размеров структур, важная роль в будущем отводится на корпусировку.
Ранее мы уже сообщали о планах TSMC по техпроцессам на ближайшие годы. В 2022 году компания уже запускает 3-нм техпроцесс, а N6 и N4 будут представлять собой оптимизированные версии 7- и 5-нм техпроцессов. С учетом все уменьшающихся размеров структур, важная роль в будущем отводится на корпусировку.
В прошлом году TSMC уже рассказала подробности 3D-корпусировки. TSMC называет ее 3D Fabric. По сути, здесь можно разделить подходы на InFO (chip first) и CoWoS (chip last). Теперь дополняется технология стекирования чипов TSMC SoIC. Данный метод как раз использует AMD для своего 3D V-Cache. А именно кристалл с 64 MB SRAM находится поверх кэша L3 на кристалле Ryzen CCD, поэтом 32 Мбайт кэша L3 получают расширение еще 64 Мбайт. TSV проходят сквозь CCD до слоя SRAM. Контактные шарики Micro bumps для связи кристаллов уже не используются. Как указывает AMD, производство первых процессоров с кэшем 3D V-cache начнется ближе к концу года.
Что вполне вписывается в планы TSMC по поводу SoIC. В четвертом квартале 2021 года TSMC планирует начать тестирование первых чипов, причем сами кристаллы будут производиться по 7-нм техпроцессу (N7-on-N7). Что как раз и требуется AMD, поскольку Zen 3 CCD и производятся по 7-нм техпроцессу. Кристалл SRAM располагается слоем выше. Для SRAM TSMC может использовать другую версию техпроцесса N7, которая оптимизирована под кэш, что позволяет уместить 64 Мбайт на площади 36 мм², затем уже этот кристалл устанавливается на 81 мм² CCD.
В третьем квартале 2022 оба чипа в стеке уже смогут производиться по техпроцессу N5. В таком случае AMD может использовать технологию для грядущих Zen 4 CCD.
TSMC планирует уменьшить временной зазор между производством обычных чипов и созданием стека к 2023 году. Между производством чипов по 7-нм техпроцессу и корпусировкой N7-on-N7 прошло четыре года, между 5 нм и N5-on-N5 пройдет три года, но между 3 нм и N3-on-N3 ожидается лишь 12 месяцев.
Поэтому технологией наверняка заинтересуются больше клиентов TSMC, поскольку она будет доступна раньше.
TSMC и Intel фокусируются на корпусировке
При производстве кристаллов можно видеть тенденцию выхода все меньших и меньших размеров структур, то есть техпроцессов, но почти все производители занимаются развитием корпусировки. И в ближайшие годы корпусировка станет еще важнее. TSMC предлагает несколько вариантов 3D Fabric, а Intel предлагает EMIB, Co-EMIB и Foveros уже не только для своих чипов, но и для сторонних клиентов в рамках концепции IDM 2.0.
Что касается процессоров, Intel последует за AMD и перейдет на чиплеты в конце 2021 года с поколением Alder Lake. На сегменте дата-центров Intel уже выбрала такой путь. Но AMD на несколько шагов обгоняет чипового гиганта, в немалой степени благодаря сотрудничеству с TSMC. Процессоры Ryzen и EPYC выходят на дизайне чиплетов уже три поколение. Следующим шагом через несколько месяцев станет 3D V-Cache.
Подписывайтесь на группы Hardwareluxx ВКонтакте и Facebook, а также на наш канал в Telegram (@hardwareluxxrussia).